반도체 공정 검사계측 혁신기술 개발
반도체 생산 공정은 공정과정 중 균일도 측정과 결함 등의 불량을 구분하기 위해선 매우 긴 측정 시간이 필요합니다. 현재 상용화돼 있는 기술적 한계 때문에 원천기술 확보는 전 세계 반도체산업의 핵심 과제 중 하나라고 하는데요.
이번 서면 인터뷰에서 만나 보실 김대석 교수 (전북대학교 기계시스템공학부)는 반도체 공정에서의 측정 기술이 갖는 속도의 한계를 극복하고 신개념 검사측정 300mm 반도체 패턴웨이퍼 anisotropy 전면적 검사계측용 초고속 Muller spectroscopic imaging mapping 기술을 연구하고 있습니다. 또한, 일체형 분광편광간섭계 기반 SPR 바이오센싱기술도 연구 중이신데요.
연구에 대한 자세한 이야기해보도록 하겠습니다.
1. 현재 교수님께서 하고 계시는 주요 연구에 대한 간단한 소개 부탁드립니다.
우리 연구실은 광계측 분야를 연구하는 Optical metrology lab(OML)이며, 주로 빛의 간섭, 회절, 편광현상에 관한 파동광학에 대한 연구를 하고 있습니다. 2007년에 시작된 OML은 처음 약 8년 동안 간섭과 회절 윈리를 이용한 분광간섭에 기반한 3차원 형상측정에 대한 연구 및 파면 계측의 고속화를 위한 digital holography 기술에 대한 연구를 주로 수행하였습니다. 하지만, 2014년부터 분광간섭기술과 편광계측기술을 융합한 새로운 개념의 초고속 Spectroscopic Ellipsometry(SE) 기술에 대한 연구를 진행해 오고 있습니다.

Spectroscopic Ellipsometry 기술은 시편에 조사된 선형 편광된 파동의 편광상태 변화를 나타내는 타원계측각(Ψ,Δ)에 대한 정보를 여러 파장에 대해 측정함으로써 반도체 CVD(Chemical Vapor Deposition) 공정 등에서 제조되는 나노 박막이나 Optical Lithography를 통해 제작되는 주기나노패턴의 3차원 형상 계측에 쓰이는 대표적인 나노계측 기술입니다.
일반적인 SE는 편광자가 360도 이상 회전을 하며 시료에 반사된 빛의 분광정보를 측정해야 하기 때문에 측정속도의 한계가 존재하며 한 점의 SE 측정을 위해 대략 수 초의 시간이 소요됩니다. 이러한 SE 속도의 한계를 극복하기 위해 우리 연구팀은 구동부가 없는 초고속 SE에 대한 원천기술(일체형 분광편광간섭변조모듈에 기반한 Dynamic spectroscopic ellipsometry 기술) 확보하였으며 독자 원천기술에 기반해 현재까지 초고속 SE mapping 시스템 개발을 완료하였으며 나아가 현재는 초고속 Muller Matrix SE mapping 기술 개발에 집중하고 있습니다.

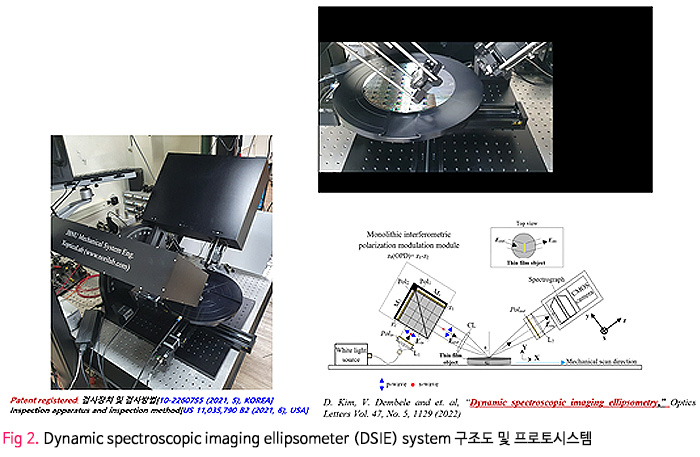
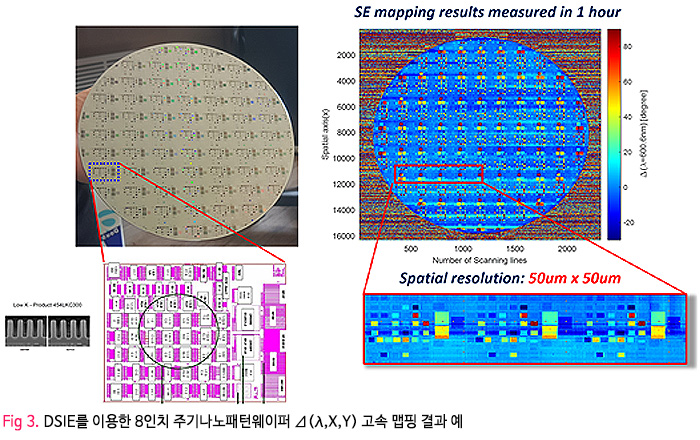

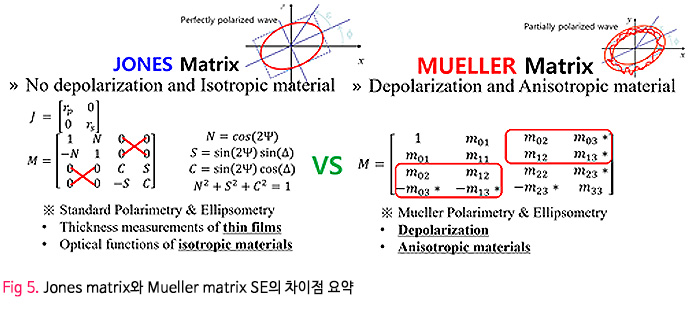
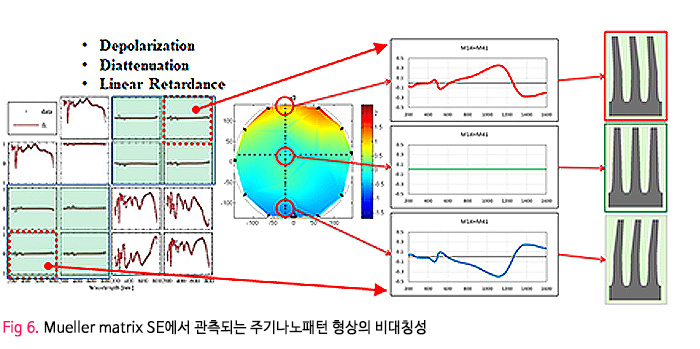
기존의 Mueller matrix SE는 4 by 4 Full matrix는 입사와 출사단에 채용된 2개의 보상자(RC2, Rotating compensator)의 회전을 통해 추출됩니다. 두 보상자는 서로 일정한 회전비(5:3 또는 5:1)를 가지고 작동되는데 Dual rotating part의 동기화를 위한 기술의 복잡성 및 고가의 구동부가 필요합니다.
하지만, 현재 연구개발 중인 고속 Mueller matrix SE 기술은 단일 구동부, 즉 RC1만을 채용함으로써 매우 단순화된 Mueller matrix SE가 될 것으로 기대합니다. Mueller matrix는 빛의 편광상태를 표현하는 Stokes vector들로 계산될 수 있는데, 우리 연구팀이 확보한 일체형 분광편광간섭변조모듈(monolithic interferometric polarization modulation module)을 채용한 20Hz 이상의 실시간 Stokes vector 측정 기술을 기반으로 반도체 대면적 웨이퍼의 전면에 대한 in-line 초고속 Mueller matrix SE 기술을 개발한다면 매우 의미있는 기술적 진보를 달성할 수 있을 것으로 기대하고 있습니다.
5. 반도체 MI(Measurement & Inspection) 기술이 매우 중요하다고 하는데요. 왜 중요한지 설명 부탁드립니다.
수백 번의 공정을 거쳐 완성되는 반도체소자는 세상에서 가장 복잡하고 정교한 공정입니다. 하나의 반도체 웨이퍼로 일반적으로 수만 개의 반도체 칩이 제작되는데 반도체의 고도화 및 집적화가 진행되면서 반도체 공정의 난이도와 불균일도 이슈가 증대되고 있습니다. 이러한 이유로 반도체 기업에서는 높은 수율(양품의 비율) 확보를 위한 MI 공정을 수행[Fig 7 참조]하고 있으며 지속적인 MI 공정의 개선이 이루어지고 있습니다.
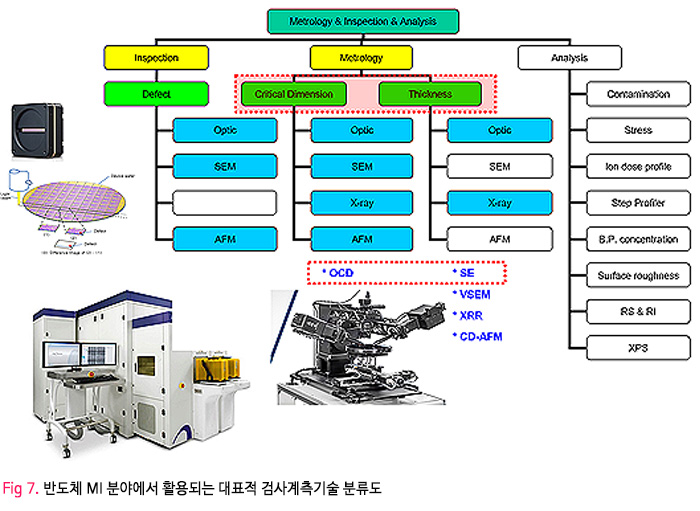
In-line MI 장비를 통한 반도체 공정의 실시간 모니터링이 반도체 생산수율을 극대화 시키는 핵심이 될 수 있습니다. Fig 7은 반도체 MI 분야의 대표적인 검사계측기술을 보여줍니다.
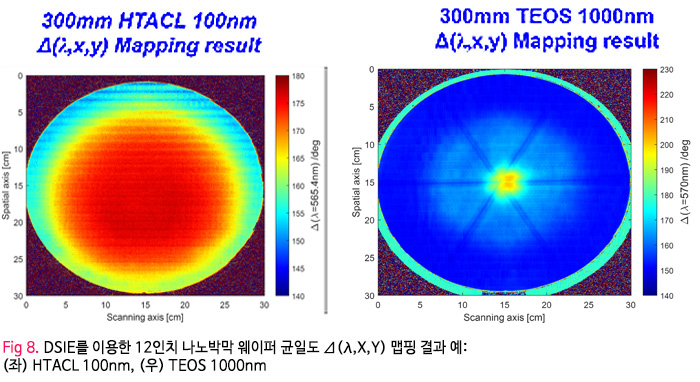
Fig 8은 우리 연구팀이 개발한 SE mapping 시스템을 이용한 반도체 CVD 박막 시료의 균일도 mapping 계측 사례를 보여줍니다. MI 기술을 이용하면 반도체 박막 및 패턴웨이퍼의 불균일을 검사하고 공정에 feedback 시켜 공정수율 향상에 결정적인 기여를 할 수 있습니다.
6. 일체형 편광간섭계기반 초고감도 high-throughput 바이오센싱 기술 개발에 대한 자세한 설명 부탁드립니다.
평평한 금속 표면에 입사하는 빛에 의해 여기되는 상태를 표면 플라즈몬이라 하며 이러한 금속체와 유전체 사이에서 발생하는 자유 전하들이 집단적인 진동 현상을 SPR(Surface plasmon resonance) 현상이라고 합니다. 이러한 물리적 현상을 기반으로, 전 세계적으로 빛의 편광 기술을 이용하여 생체분자 간의 상호작용을 고감도 및 실시간으로 모니터링할 수 있는 label-free SPR 바이오 센싱 기술이 연구되고 있습니다.
SPR 현상은 오직 P-편광 빔에 의해서만 발생하는데 우선, 프리즘과 금 박막, 유전물질로 구성된 SPR 감지 모듈에 P-편광 빔(p-polarized wave)을 조사시키면 금속체와 유전체의 유전 상수에 의존적으로 특정 각도 또는 파장이 표면 플라즈마 파와 결합하여 광학적 최소 반사율(SPR dip)을 발생하며, 이는 감지표면에 있는 유전물질의 굴절률 변화에 매우 민감하게 반응합니다 [Fig 9(a)].
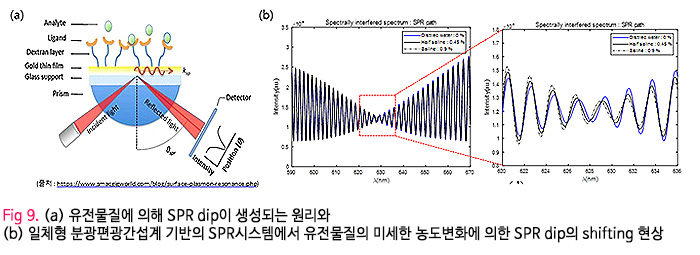
다시 말해서, 단백질 및 DNA, 항체-항원 반응과 같이 생체분자 간의 반응에서 발생하는 미소한 굴절률 변화를 감지할 수 있는 센싱 기술입니다. SPR의 이러한 민감한 특성은 환경 모니터링, 바이오와 같은 다양한 분야에서 활용됩니다. 대부분 상용 SPR 센서는 입사각 또는 파장에 따라 나타나는 Intensity 감소에 의한 SPR dip을 측정하거나, 고정된 빛의 입사 각도에서 파장 spectrum의 SPR dip 위치를 측정합니다.
최근 전 세계 독립적인 연구팀들은 저분자량 생체 반응에 대한 센싱 감도를 향상하기 위해 기존 SPR 센서의 빛의 강도 측정 방법이 아닌 위상 측정 방법에 관한 연구를 시도하고 있습니다. 이들은 특수제작된 복굴절 물질에서 생성된 넓은 스펙트럼을 통해 바이오센서 기술의 민감도 향상은 물론, 측정 영역(dynamic range)을 확장하기 위한 연구를 진행중입니다. 그러나 이러한 복굴절 소자는 SPR 위상 측정 기술의 RI(Refractive index unit) 검출한계와 관련한 고주파 분광반송주파수의 변경이 불가하고, 고주파 분광반송주파수를 발생시키는 광학적 이방 소자가 온도에 의존적이기 때문에 온도 제어 장치 없이 정밀한 굴절률 변화를 감지하기 어렵습니다.
현재 본 연구팀에 의해 개발된 일체형 편광간섭계 기반 SPR 바이오센싱 기술은 디자인이 flexible하기 때문에 상황에 따라 자유롭게 분광반송주파수의 변경이 가능한 장점이 있고, 외란에 대한 위상 오차 보상 연구를 통해 고정밀 온도 제어 없이 1.4X10-6RIU(Refractive index unit) 수준의 검출한계를 달성 가능합니다 [Fig 9(b)].
향후 정밀 온도 제어가 갖춰진 환경에서는 10-8RIU 수준까지 개선 가능할 것으로 예상됩니다. 또한 본 연구팀은 Dynamic spectroscopic imaging ellipsometer 기술의 확장 및 적용연구를 통해 현재 바이오센서 칩의 고생산성에 대한 솔루션을 제공함은 물론 SPR 이미징 바이오센싱 기술을 선도할 것으로 기대하고 있습니다.
7. 여전히 메모리 반도체 위주인 국내 업계에서 시스템 반도체 산업을 키우기 위해 어떤 노력이 필요한가요? 그리고, 반도체 소재, 부품, 장비까지 생산 및 제조과정에서 수입 의존도가 매우 높다고 하는데요. 교수님의 견해는 어떤지 궁금합니다.
시스템 반도체 산업 성장의 핵심은 반도체 설계 능력과 지속적인 연구개발 투자에 있을 것입니다. 이에 각 대학에서는 반도체 전문인력양성을 위한 신설학과 개설 및 교육프로그램 신설 등 다양한 시도를 하고 있으며 이에 정부와 산업계의 관심이 동반되는 적극적인 노력이 필요합니다.
현재 시스템 반도체를 포함한 차세대 반도체산업의 발전을 위해 정부 차원의 다양한 장기 연구개발 과제가 추진되고 있습니다. 예로, 과학기술정보통신부(‘20~’29)와 산업통상자원부(‘20~’26)의 협력으로 진행되고 있는 약 1조원 규모의 차세대지능형반도체사업단이 대표적인 정부지원 과제입니다.
하지만, 반도체 패권 확보를 위한 세계 반도체 장비산업의 독점화가 급속히 진행되고 있는 현 상황을 고려해 볼 때, 현재 해외 장비기술에 큰 의존 중인 국내 반도체 장비산업의 경쟁력 확보 및 나아가 글로벌 반도체 장비산업의 선도를 위한 지속적인 연구 인재양성과 원천기술 확보가 중요하다고 생각합니다. 제가 사업팀장으로 있는 2020년부터 진행되고 있는 BK21 FOUR “Intelligence 기반 정밀 부품장비 시스템엔지니어양성사업팀”도 작지만 이러한 반도체 산업의 전문인력을 키우기 위한 노력의 일환입니다.
8. 반도체의 추세가 미세화 및 고적층화로 가면서 반도체 계측 및 검사 시스템 또한 이에 대응하는 기술혁신이 중요하다고 하는데요. 현재 반도체 계측 및 검사 시스템 분야의 국내 상황과 국외 상황을 구체적으로 비교해주신다면 어떤 실정인가요?
현재 국내외 반도체 생산라인에 적용된 대부분의 반도체 검사측정장비는 미국의 KLA사가 거의 독점하고 있으며 반도체 전공정 MI뿐 아니라 차세대 반도체 공정에 필요한 웨이퍼레벨 패키징 MI까지의 거의 모든 주요 공정의 계측검사 solution을 제공하고 있습니다. 반도체 검사계측 장비의 중요성이 강조됨에 따라 국내 반도체장비기업의 국산화 도전이 다양하게 시도가 되고 있습니다.

국내 대표 반도체 MI기업으로는 Overlay 기술의 Auros Technology, defect 검사기술의 Nextin, AFM 기술의 Park Systems가 있습니다. 하지만, 여전히 반도체 검사장비는 반도체 생산 수율과 직접적으로 관여되기 때문에 반도체 업계에서는 매우 보수적으로 역사와 기술력이 뒷받침되는 해외 기업을 선호하고 있는게 현실입니다.
9. 기존 시스템 반도체에 인공지능(AI) 프로세서를 탑재해 저전력, 초고속 연산이 가능한 NPU(Neural-Processing-Unit), 초고속 카메라, 3D 스마트 센서 등 차세대 반도체 검사 및 계측을 한다고 하는데요. 교수님의 견해는 어떤지 궁금합니다.
PIM(Processor in Memory), NPU(Neural Processing Unit) 등의 차세대 반도체에서의 검사계측 기술 또한 기본적으로 기존 메모리반도체 산업 등에서 사용되었던 OCD, AFM, SEM 등의 nano metrology 기술이 계측기술의 기본이 됩니다. 하지만, 기존의 메모리와 프로세서의 융합이 일어나는 과정에서 발생하는 다양한 복합소자에 대한 MI 대응을 위해 기존 광계측검사기술의 융합이 필요한 시점으로 판단됩니다. 마이크로나노 3차원 계측에 대한 필요성도 새롭게 도출되고 있으며 웨이퍼레벨 패키징에 관련한 고속 3차원 계측검사기에 대한 수요도 새롭게 도출되고 있다고 생각됩니다. 요약하면, 기존 MI기술 간의 융합연구가 점점 더 중요해지고 있는 상황이라고 판단됩니다.
10. 최근 반도체 생산 공정 기술에 대한 개발 현황과 향후 전망에 대해서 궁금합니다.
최신 반도체 생산공정기술 중 ASML사의 EUV Lithography 장비기술이 현 반도체산업에 가장 큰 영향을 주고 있는 공정 장비기술임은 매스컴을 통해서 너무나 잘 알려져 있는 사실입니다.[Fig 11(a)]
20년 이상의 R&D 기간을 통해 네덜란드의 ASML에서 상용화된 이 기술은 현재의 2nm CD를 가능하게 하는 핵심공정기술입니다. ASML사는 Fig 11(b)와 같이 holistic lithography 개념을 소개하고 있으며 After-Litho, After-Etch e-beam metrolgy를 포함한 Lithography 장치 내부에 integrated scanner metrology 개념을 채택하는 독자적인 MI 기술을 개발하고 EUV Lithography의 성능 및 수율의 최적화를 핵심 전략으로 추진하고 있습니다. 본 사례에서 확인할 수 있듯이 향후 반도체 생산공정 장비는 다양한 integrated MI 기술과의 융합이 매우 중요한 경쟁력이 되리라 생각하고 있습니다.
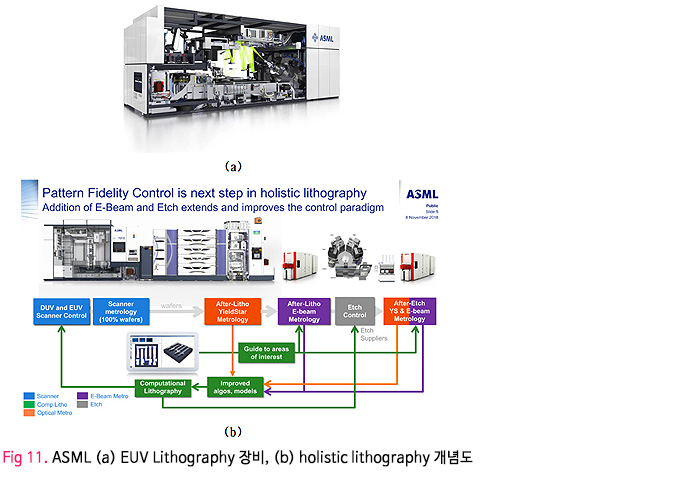
11. 연구 진행 중 어려운 점이 있었다면 어떤 점이었으며, 어떻게 해결해 오셨는지 알려주세요.
Dynamic spectroscopic ellipsometry의 고속 측정의 핵심은 일체형 편광간섭계에 있습니다. 광 경로차에 의해 발생되는 고주파 반송주파수에 포함된 시편에서 변화된 편광정보를 추출합니다. 정확한 타원계측각 추출을 위해서는 광 경로차(OPD, Optical path difference)를 일정하게 유지시켜야 합니다. 하지만 빛의 간섭은 매우 민감해서 미세한 온도의 변화나 진동 또는 공기유동에 의해 OPD가 쉽게 변화하기 때문에 시편의 정보에 불안정한 위상에러가 포함된 타원계측각이 추출되므로 정밀도가 크게 저하되는 문제가 있었습니다. 하지만 이러한 불안정 요소들은 시편 입사 전 빛을 두 경로로 나누어 하나의 경로에서는 시편을 측정하고, 다른 하나는 시편의 정보가 포함되지 않은 간섭계만의 위상에러를 실시간으로 모니터링 함으로써 해결 될 수 있습니다.
최근 우리 연구팀은 기존대비 수백 배 향상된 정밀도를 확보하였고, 이는 최근 미국광학회지(OSA)의 저널인 Applied optics에 게재되었습니다.

Fig 12은 이러한 Long term stability 이슈를 SE mapping system에 적용하여 달성한 10시간 동안의 결과를 보여줍니다. 전술한 초고속 SE mapping 기술의 상용화 가능성을 열어준 핵심적인 문제해결이 아래의 Long term stability 해결연구였습니다.
12. 이런 연구에 힘입어 앞으로 연구 계획 중인 연구나 또 다른 목표가 있으신지 궁금합니다.
Spectroscopic Ellipsometry 기술은 반도체 CVD(Chemical Vapor Deposition) 공정 등에서 제조되는 나노 박막이나 Optical Lithography를 통해 제작되는 주기나노패턴의 3차원 형상 계측에 사용되는 대표 나노계측 기술입니다.
우리 연구팀은 지난 약 7년간의 연구를 통해 고정밀도의 초고속 SE 및 SE Mapper 원천기술에 대한 지적재산권을 대한민국, 미국에서 확보하였으며 현재 Fig 12과 같이 다양한 design concept의 prototype 시스템을 개발하고 기술이전을 포함 다양한 기술 상용화 노력을 지속적으로 하고 있습니다. 또한, 새로운 연구과제 주제인 초고속 Muller Matrix SE mapping 연구를 포함해 현재 차세대 반도체 MI에 적용할 수 있는 micronano 3D 계측검사 기술에 대한 연구도 진행하고 있습니다.

13. 앞으로 관련 분야를 공부하는 후학(대학원생들)에게 이 분야의 연구에 대한 비전을 제시해 주신다면.
전술한 ASML holistic lithography 개념에서 소개했듯이 차세대 반도체 공정기술을 위한 MI 기술의 지속적인 연구와 도전은 전 세계 반도체산업의 승패를 좌지우지할 정도의 기술적 산업적 의미를 가질 수 있다고 믿고 있습니다.
반도체 생산공정 장비는 향후 다양한 integrated MI 기술과의 융합이 이루어질 것으로 전망하고 있으며 나아가 신개념의 MI 기술개발을 통해 반도체 smart factory의 혁신이 이루어질 것입니다.
후학들의 관심을 통해 반도체 검사계측기술 분야에 대한 전문성을 갖춘 더 많은 인력이 길러질 수 있다면 현재의 국내 MI 장비산업은 비약적으로 발전할 것을 확신하며, 좀 더 장기적인 관점에서 이 분야의 투자가 이루어진다면 충분히 세계적으로 경쟁력 있는 인력과 기업들이 만들어질 수 있다고 생각합니다.
Notice & News
OML의 최신중요정보 및 새로운 소식을 공유하는 공간입니다.